Тема 5. Загальні відомості про принципи роботи і характеристики напівпровідникових приладів
| Site: | Освітній сайт КНУБА |
| Course: | Основи електротехніки та електроніки (Ковал) |
| Book: | Тема 5. Загальні відомості про принципи роботи і характеристики напівпровідникових приладів |
| Printed by: | Гість-користувач |
| Date: | Tuesday, 3 March 2026, 2:02 PM |
Description
1. Елементи зонної теорії
1.1. Механізм власної провідності напівпровідників
1.2. Мехнізм домішкової провідності напівпровідників
1.3. Електронно-дірковий перехід
1.4. Вольт-амперна характеристика р-n-переходу
1. Елементи зонної теорії
За
здатністю проводити електричний струм усі речовини умовно поділяють на
провідники, діелектрики та напівпровідники. У першому наближенні
напівпровідники виділяють з інших речовин за значенням питомого електричного
опору ρ . Вважають, що при кімнатній температурі у металів питомий електричний
опір менший від ![]() , у діелектриків – більший від
, у діелектриків – більший від ![]() , а напівпровідникові матеріали займають
проміжне місце між металами і діелектриками, тобто мають ρ від
, а напівпровідникові матеріали займають
проміжне місце між металами і діелектриками, тобто мають ρ від ![]() до
до ![]() .
.
1.1. Механізм власної провідності напівпровідників
Така кількісна класифікація не є вичерпною, оскільки не всі речовини із зазначеними значеннями питомого опору є напівпровідниками. Різниця між напівпровідниками і діелектриками в цілому кількісна, а от характер провідності напівпровідників і металів зовсім різний: у металів питомий опір зростає із збільшенням температури, а у напівпровідників – зменшується. Напівпровідники відрізняються від інших речовин сильною залежністю їх питомого опору від температури, освітлення, наявності домішок тощо, а також механізмом провідності, а саме: наявністю двох типів зарядів: електронів і дірок. Серед напівпровідників розрізняють прості і складні напівпровідникові матеріали. Самостійне застосування серед простих напівпровідників знайшли кремній (Si), германій (Ge) і селен (Se). До групи складних напівпровідників входять хімічні сполуки із двох чи більше хімічних елементів, які позначають буквами латинської абетки з позначенням групи елемента згідно до таблиці Д. І. Менделєєва:
![]() – фосфід індію (InP), фосфід галію (GaP), арсенід галію (GaAs), стибад індію
(InSb), стибад алюмінію (AlSb) та інші;
– фосфід індію (InP), фосфід галію (GaP), арсенід галію (GaAs), стибад індію
(InSb), стибад алюмінію (AlSb) та інші;
![]() – CdSb, ZnSb та інші;
– CdSb, ZnSb та інші;
![]() – ZnS, ZnSe, телурид цинку (ZnTe), сульфід кадмію (CdS), CdTe, HgSe, HgTe, HgS та інші;
– ZnS, ZnSe, телурид цинку (ZnTe), сульфід кадмію (CdS), CdTe, HgSe, HgTe, HgS та інші;
![]() – PbS, PbSe, PbTe, SnS, SnSe, GeS, GeSe та інші;
– PbS, PbSe, PbTe, SnS, SnSe, GeS, GeSe та інші;
карбіди (SiC), оксиди (Cu2O, ZnO) і багато інших хімічних сполук.
Напівпровідники, як правило, – це тверді тіла з регулярною кристалічною структурою (монокристали). Їх кристалічні ґраткискладаються з елементарних осередків тієї чи іншої форми й розміру, що прилягають один до одного. Знайомство з процесами внапівпровідниках проводять на прикладі кремнію чи германію і поширюють отримані закономірності на весь клас напівпровідникових матеріалів.
З молекулярної фізики відомо, що зв’язок між атомами елементів, які входять до складу простих або складних речовин, виникає внаслідок електромагнітної взаємодії позитивно заряджених ядер і негативно заряджених електронів. Порядковий номер хімічного елемента співпадає з кількістю електронів, що створюють електронні оболонки атома, причому кількість електронів на зовнішній електронній оболонці в елементах головних підгруп дорівнює номеру групи в Періодичній системі. Саме ці електрони слабко зв’язані з ядром атома і беруть участь у хімічних реакціях. Їх називають валентними електронами. Електрони, які рухаються за замкненими орбітами навколо ядра, не можуть мати довільні значення енергії, а тільки квантовані дискретні значення. Чим далі від позитивно зарядженого ядра, тим більшу енергію має електрон. Найвищі енергетичні рівні займають валентні електрони. При збільшенні температури речовини або в результаті опромінення електрони можуть набути додаткову енергію і перейти на більш віддалену від ядра атома орбіту, тобто стати збудженими. У разі отримання валентним електроном енергії, що перевищує роботу виходу, електрон вилітає за межі кристала.
Якщо атоми елементів, що взаємодіють між собою, мають однакову електронегативність, то між ними створюється неполярний ковалентний хімічний зв’язок за допомогою спільних електронних пар із валентних електронів, які однаковою мірою належать обом атомам. Атоми різних елементів характеризуються різною електронегативністю, що веде до зміщення електронної пари ближче до атома з більшою кількістю електронів на зовнішній оболонці і створення полярного ковалентного зв’язку. Йонний зв’язок утворюється, якщо через дуже значну різницю електронегативності валентні електрони переходять до одного із атомів. Більшість твердих речовин мають кристалічну будову. Залежно від типу частинок, що містяться у вузлах кристалічних ґраток, розрізняють йонні, атомні, молекулярні та інші ґратки.
Типові напівпровідники – це прості речовини кремній та германій, які створені із атомів елементів IV групи Періодичної системи елементів Менделєєва відповідно Силіцію (14Si) та Германію (32Ge). У кристалічних ґратках простих речовин, утворених атомами елементів IV групи, кожний атом сполучений 4 неполярними ковалентними зв’язками з чотирма сусідніми атомами (рис. 1.1,а). Атомні ґратки складаються із тетраедрів, в кутах і центрах яких розміщені атоми (рис. 1.1,б). Відстань між центральним і кутовими атомами однакова, близько 0,25 (нм). Кожний кутовий атом, у свою чергу, слугує центральним для інших чотирьох найближчих атомів. Сукупність декількох тетраедрів утворює елементарний осередок кубічної форми з розміром ребра близько 0,5 (нм). Подібну структуру має і алмаз, що зумовило назву структури – ”ґратки типу алмазу”. Кристал такої структури нагадує велетенську молекулу і характеризується великою твердістю, високою температурою плавлення та слабкою розчинністю.
Зауваження. 1. У кристалах напівпровідників спостерігається явище анізотропії, тобто залежності властивостей від напряму. Тому пластини під час виготовлення інтегральних схем шліфують точно вздовж заданої кристалографічної площини.
2. Структура тонкого приповерхневого шару пластини із напівпровідника завжди відрізняється від структури основного об’єму внаслідок порушення ковалентних зв’язків і відновлення рівноваги за рахунок змін відстаней між атомами й захватів чужорідних атомів із зовнішнього оточення.

Рис. 1.1. Кристалічні ґратки кремнію: кубічний осередок (а),
елементарний тетраедр (б) і його умовне зображення (в)
У твердому тілі атоми сильно взаємодіють між собою, що веде до створення енергетичних зон замість дискретних енергетичних рівнів окремих атомів (рис. 1.2). Аналіз провідності речовин базується саме на зонній теорії твердого тіла.

Рис. 1.2. Зонні структури речовин: металів (а),
діелектриків (б) і напівпровідників (в) при ![]()
Сукупність
енергетичних рівнів валентних електронів зовнішніх оболонок атомів ідеального
кристала утворює на енергетичній діаграмі валентну зону. Валентні електрони приймають участь
в електричних та хімічних процесах. Рівні, що відповідають меншій енергії
електронів, входять до складу інших зон, заповнених електронами. Ці нижчі
енергетичні зони не відіграють ніякої ролі у явищі електропровідності
напівпровідника, тому не зображені на рис. 1.2. За температури абсолютного нуля
(![]() ) і відсутності домішок в кристалі всі
валентні електрони беруть участь в хімічних зв’язках атомів речовини, отже, всі
енергетичні рівні у валентній зоні заповнені. Якщо енергія валентного електрона
збільшується через додатковий вплив, він може стати вільним, тобто покинути
атом. Таке вивільнення означає перехід електрона у зону провідності.
) і відсутності домішок в кристалі всі
валентні електрони беруть участь в хімічних зв’язках атомів речовини, отже, всі
енергетичні рівні у валентній зоні заповнені. Якщо енергія валентного електрона
збільшується через додатковий вплив, він може стати вільним, тобто покинути
атом. Таке вивільнення означає перехід електрона у зону провідності.
У
напівпровідниках і діелектриках валентна зона й зона провідності
розділені забороненою зоною, у металів ці зони перекриваються навіть при температурі абсолютного нуля.
Невеличкої кількості енергії, яку отримує електрон, досить для того, щоб
піднятися на вищий рівень у зоні провідності металу (рис. 1.2,а) і почати
вільний рух. Напівпровідники з ідеальними кристалічними ґратками (напівпровідники і-типу) за температури абсолютного
нуля не мають вільних носіїв заряду в зоні провідності, отже, є справжніми
ізоляторами. Ширина забороненої зони у напівпровідниках суттєво менша, ніж в
діелектриках ![]() (рис. 1.2,б,в). До діелектриків
відносять речовини з шириною забороненої зони у кілька електрон-вольт
(рис. 1.2,б,в). До діелектриків
відносять речовини з шириною забороненої зони у кілька електрон-вольт ![]() . Напівпровідникові матеріали,
що знаходять технічне використання, мають
. Напівпровідникові матеріали,
що знаходять технічне використання, мають ![]() . Так, для германію ширина забороненої
зони становить
. Так, для германію ширина забороненої
зони становить ![]() , для кремнію –
, для кремнію – ![]() , для хімічної сполуки арсеніду галію –
, для хімічної сполуки арсеніду галію – ![]() .
.
Зауваження. Електрон-вольт
(еВ) – це енергія, якої набуває електрон під дією прискорювальної напруги 1
(В): ![]() .
.
З підвищенням температури чи внаслідок опромінення кристала збільшується енергія валентних електронів. Як тільки валентний електрон отримує додаткову енергію, що перевищує енергію забороненої зони, він переходить у зону провідності, звільняючи енергетичний рівень у валентній зоні. На тому місці, де раніше був електрон, з’являється вільне («вакантне») місце – дірка. Вакантний енергетичний рівень – дірку – можна вважати за носій заряду, величина якого дорівнює заряду електрона, але позитивної полярності. Під переміщенням дірки потрібно розуміти заповнення дірки в валентній зоні атома електроном із оболонки сусіднього атома. На місці цього електрона виникає нова дірка, і процес повторюється. Отже, дірка поводить себе подібно до частинки з додатним елементарним зарядом.
Втративши валентний електрон, атом перетворюється на додатний йон (рис. 1.3).
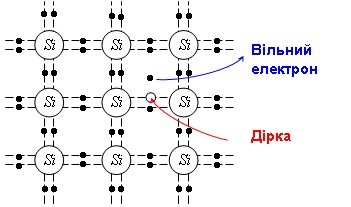
Рис. 1.3. До пояснення процесу генерації пари електрон-дірка
Процес
утворення пари – електрон в зоні провідності та дірка у валентній зоні – називають генерацією. Процес утворення
електронно-діркових пар при нагріванні кристала напівпровідника має назву термогенерація. Кількість носіїв зарядів
збільшується вдвічі зі збільшенням температури германію на ![]() і кремнію на 8оС. Генерація пар електрон-дірка під дією світла, рентгенівських та
і кремнію на 8оС. Генерація пар електрон-дірка під дією світла, рентгенівських та ![]() -променів на відміну від нагрівання локальна,
тобто визначається площею пучка.
-променів на відміну від нагрівання локальна,
тобто визначається площею пучка.
Електрони
в зоні провідності та дірки у валентній зоні перебувають у хаотичному русі. При
цьому має місце процес захоплення електронів дірками. Процес зникнення пари
електрон-дірка називається рекомбінацією. Середню тривалість існування пари електрон-дірка між
моментами генерації й рекомбінації називають часом життя носіїв заряду. Середня відстань, на яку
переміщуються носії зарядів за час життя, – це дифузійна довжина носіїв заряду (типові значення
0,2…3(мкм)). Перехід електрона з вищого енергетичного рівня провідності на
нижчий рівень валентної зони супроводжується вивільненням енергії, яка
передається кристалічним ґраткам або випромінюється у вигляді кванта світла. Із
збільшенням температури зростає як кількість генерацій за одиницю часу, так і
кількість рекомбінацій. Для кожного значення температури встановлюється
динамічна рівновага, а концентрації (кількість носіїв в одиниці об’єму)
дірок ![]() та електронів ni у напівпровіднику без домішок
дорівнюють одна одній:
та електронів ni у напівпровіднику без домішок
дорівнюють одна одній: ![]() . При кімнатній температурі (25oC), для Ge:
. При кімнатній температурі (25oC), для Ge: ![]() , для Si:
, для Si: ![]() , для GaAs:
, для GaAs: ![]() . Зрозуміло, що чим більша ширина забороненої
зони, тим менша кількість вільних носіїв заряду.
. Зрозуміло, що чим більша ширина забороненої
зони, тим менша кількість вільних носіїв заряду.
За
наявності електричного поля електрони рухаються проти напруженості поля, а
дірки – в напрямі напруженості поля. Зручно розглядати електричний струм у
напівпровіднику як суму двох струмів: електронного та діркового. Провідність напівпровідника,
яка зумовлена генерацією парних носіїв електрон-дірка під дією зовнішніх
чинників (нагрівання, опромінення), має назву власна провідність напівпровідника. Власна провідність напівпровідника має
дві складові: електронну та діркову.
Незважаючи на однакову кількість електронів та дірок у напівпровіднику і-типу,
електронна провідність перевищує діркову, що пояснюється більшою рухомістю
електронів провідності порівняно з рухомістю дірок. Зрозуміти це легко, якщо
пригадати, що діркова провідність являє собою більш обмежене переміщення
електронів, ніж рух вільних електронів. Електрони і дірки рухаються у
протилежних напрямах, але електронна і діркова складові струму додаються, тому
що рух дірок є насправді рухом електронів. Наприклад, якщо у напівпровіднику
і-типу електронна складова струму ![]() , а діркова –
, а діркова – ![]() , то повний струм провідності
, то повний струм провідності ![]() .
.
Упорядкований рух електронів і дірок під дією електричного поля називають дрейфом, а рух носіїв зарядів із зони з більш високою їх концентрацією в зону з меншою концентрацією – дифузією.
1.2. Мехнізм домішкової провідності напівпровідників
Будь-який реальний напівпровідник містить домішки і має дефекти кристалічної ґратки. Атоми домішок можуть бути розташовані між вузлами ґратки (домішки занурення) чи у самих вузлах ґратки замість основних атомів (домішки заміщення).Мізерні кількості домішок заміщення різко змінюють електричні властивості напівпровідників – збільшують їх провідність. Наприклад, 10-5 атомів Арсену в германії знижують опір останнього у 200 разів. Провідність напівпровідника, яка обумовлена наявністю атомів домішок заміщення, називають домішковою провідністю напівпровідника. Можливість керування електропровідністю домішкових напівпровідників широко використовують в сучасній електронній промисловості для надання напівпровідникам заданих властивостей. Розрізняють домішкові електропровідності n-типу і р-типу.
При
внесенні в попередньо очищений чотиривалентний напівпровідник Ge чи Si домішки
п’ятивалентного елемента (наприклад, Арсену (As), Стибію (Sb) або Фосфору (Р))
атоми домішки заміщають у вузлах кристалічних ґраток атоми напівпровідника
(рис. 1.4,а)). При цьому чотири валентні електрони кожного атома домішки,
об’єднавшись з чотирма електронами сусідніх атомів напівпровідника,
налагоджують тетраедричну систему ковалентних зв’язків, а п’ятий електрон
кожного атома домішки виявляється надлишковим і дуже слабко зв’язаним з атомом.
Енергетичний рівень домішки розміщується на зонній діаграмі напівпровідника у
забороненій зоні поблизу нижньої границі зони провідності (рис. 1.4,б)). Вже
при кімнатній температурі надлишкові електрони долають невеликий бар’єр
шириною ![]() , переходять у зону провідності і стають
вільними (рис. 1.4,в)), тобто можуть вільно переміщуватися всередині кристала і
забезпечувати проходження електричного струму. При цьому домішкові атоми
перетворюються на позитивні йони.
, переходять у зону провідності і стають
вільними (рис. 1.4,в)), тобто можуть вільно переміщуватися всередині кристала і
забезпечувати проходження електричного струму. При цьому домішкові атоми
перетворюються на позитивні йони.
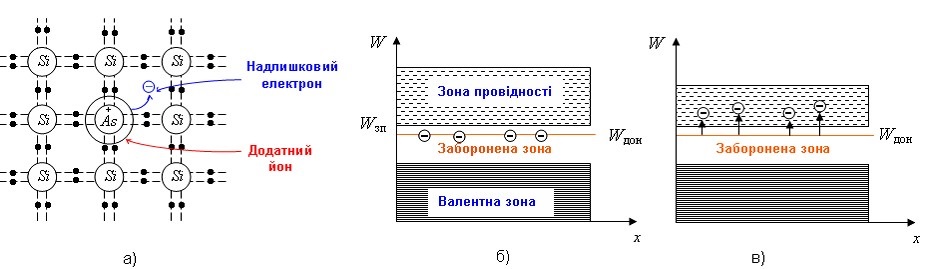
Рис. 1.4. До пояснення утворення напівпровідника n-типу:
структура кристалічної ґратки кремнію з атомом донорної домішки (а),
зонна діаграма напівпровідника n-типу за температури T=0oK (б) і кімнатній температурі (в)
Домішка, внесення якої збільшує концентрацію вільних електронів, називається донорною. Електропровідність напівпровідника з донорною домішкою забезпечується, головним чином, електронами, і тому такий напівпровідник називають n-напівпровідником чи напівпровідником n-типу (від англ. negativе). Основними носіями заряду в напівпровіднику n-типу є електрони, а неосновними – дірки. Хоча кількість атомів домішки дуже незначна і строго дозується (приблизно 1 атом домішки на 107 - 108 атомів напівпровідника) провідність напівпровідника з домішкою при кімнатній температурі зростає у декілька десятків разів.
Після внесення у попередньо очищений чотиривалентний напівпровідник Ge чи Si атомів елементів III групи (наприклад, Індію (In), Галію (Ga) або Бору (В)) атоми домішки заміщають у вузлах кристалічних ґраток атоми основного кристала напівпровідника. Однак, у цьому випадку при комплектуванні кожної тетраедричної системи ковалентних зв’язків у разі наявності атома домішки одного електрона не вистачає, оскільки атоми домішки мають лише три валентні електрони, і створюється дірка (рис. 1.5,а)). За температури абсолютного нуля такі дірки не заповнюються електронами, тому що мають енергетичний рівень, який трохи (на 0,1 (еВ)) перевищує верхню границю валентної зони напівпровідника (рис. 1.5,б)). При кімнатній температурі енергія валентних електронів збільшується і дірки можуть бути заповнені збудженими електронами внаслідок розривів будь-яких сусідніх ковалентних зв’язків. При цьому атоми домішки перетворюється на негативні йони, у валентній зоні кремнію з’являються дірки (рис. 1.5,в)).
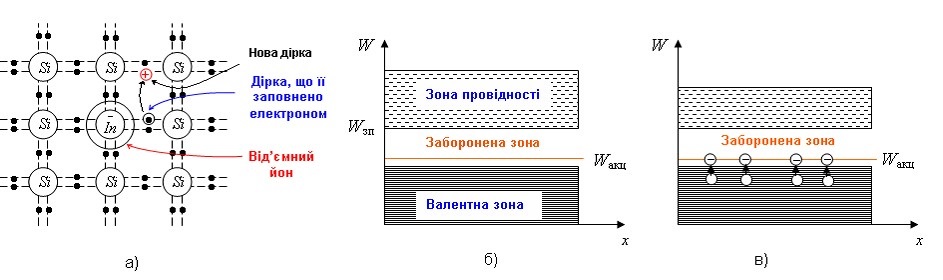
Рис. 1.5. До пояснення утворення напівпровідника р-типу:
структура кристалічної ґратки кремнію з атомом акцепторної домішки (а),
зонна діаграма напівпровідника р-типу за температури T=0oK (б) і кімнатній температурі (в)
Домішка, введення якої зумовлює створення дірок у валентній зоні напівпровідника, називається акцепторною. Напівпровідник з акцепторною домішкою має, головним чином, діркову провідність або провідність р-типу (від англ. positive) і називається p-напівпровідником. Основними носіями заряду в напівпровіднику р-типу є дірки, а неосновними – електрони.
Повна провідність напівпровідника з введеною домішкою визначається сумою власної та домішкової провідностей. За низьких температур домішкова провідність перевищує власну провідність; за високих температур, коли всі атоми домішок йонізовані, власна провідність напівпровідника може перевищувати домішкову провідність. При внесенні в напівпровідник одночасно донорних і акцепторних домішок характер домішкової провідності залежатиме від того, яка з них створює більшу концентрацію носіїв заряду.
Щоб
домішкова провідність превалювала над власною, концентрація атомів донорної
домішки NД або акцепторної домішки NA має перевищувати концентрацію
власних носіїв заряду і-напівпровідника ![]() . Наприклад, для кремнію, у якого при
кімнатній температурі
. Наприклад, для кремнію, у якого при
кімнатній температурі ![]() , NД або NA можуть дорівнювати
, NД або NA можуть дорівнювати ![]() , тобто в 100-10 000 разів перевищувати власну концентрацію основних носіїв заряду.
Якщо
, тобто в 100-10 000 разів перевищувати власну концентрацію основних носіїв заряду.
Якщо ![]() , то можна знехтувати власною провідністю при
аналізі процесів у напівпровіднику. Як бачимо, дуже
незначна кількість домішки суттєво змінює характер електропровідності
напівпровідника. Цікавим є факт, що концентрація неосновних носіїв заряду
у домішковому напівпровіднику зменшується у стільки ж разів, у скільки збільшується
концентрація основних носіїв. Це означає, що завжди виконується співвідношення:
, то можна знехтувати власною провідністю при
аналізі процесів у напівпровіднику. Як бачимо, дуже
незначна кількість домішки суттєво змінює характер електропровідності
напівпровідника. Цікавим є факт, що концентрація неосновних носіїв заряду
у домішковому напівпровіднику зменшується у стільки ж разів, у скільки збільшується
концентрація основних носіїв. Це означає, що завжди виконується співвідношення:
|
|
|
Отримання напівпровідників з такою малою і строго дозованою кількістю домішки є складним технологічним процесом. До того ж напівпровідник має бути попередньо очищеним, тобто для германію сторонні домішки допускаються у кількості не більш від 10-8%, а для кремнію – 10-11%.
Зауваження. Типовими технологічними процесами внесення домішок в попередньо очищений напівпровідник є легування шляхом дифузії або йонної імплантації (див. Лекцію № 4, § 4.2.3). Окрім цього, можна нарощувати шари напівпровідників заданого типу провідності в процесі епітаксії (див. Лекцію № 4, § 4.2.1).
1.3. Електронно-дірковий перехід
Електронно-дірковим або р–n-переходом називають перехідний шар на межі двох областей напівпровідника з різними типами провідності. Такий перехід є «основною деталлю» більшості напівпровідникових приладів. Це означає, що робота більшості напівпровідникових приладів (діодів, транзисторів, тиристорів та інших) ґрунтується на використанні властивостей одного чи кількох р–n-переходів.
Технологічні процеси утворення р–n-переходу можуть бути різними: це сплавлення, епітаксія (орієнтований ріст кристала одного типу на поверхні іншого), дифузія однієї речовини в іншу [ див. Лекцію № 4, § 4.2.1, § 4.2.3] та інші.
За конструкцією електронно-діркові переходи можуть бути симетричними і несиметричними (див. § 1.3.1), площинними і точковими.
Площинний р–n-перехід являє собою шарово-контактний елемент в об’ємі кристала на межі двох напівпровідників з провідностями р- і n-типів (рис. 1.6,а)). Лінійні розміри площини переходу більші за його товщину. Площинний р–n-перехід створюється під час процесів дифузії однієї речовини в іншу або епітаксіального нарощування шару напівпровідника з певними властивостями на інший шар напівпровідника.
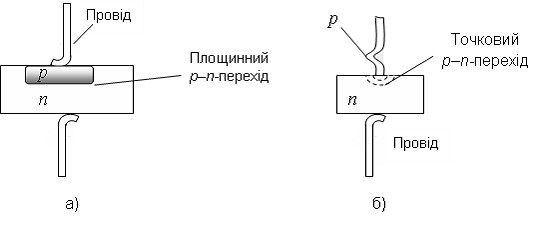
Рис. 1.6. Площинний (а) та точковий (б) р–n-переходи
Точкові переходи створюються формовкою: крізь контакт металевої голки й пластини напівпровідника (рис. 1.6,б)) пропускають великий струм (декілька амперів). Відбуваються сильне нагрівання і часткове розплавлення обох речовин у місці контакту. В результаті дифузії атомів матеріалу голки в напівпровідник змінюється тип провідності в тонкому шарі напівпровідника, що прилягає до голки. Наприклад, якщо пластинка германію має n-провідність, а голка із берилієвої бронзи, то відбувається дифузія Берилію (4Вe) в германій, і створюється тонкий р-шар напівпровідника напівсферичної форми. Внаслідок малої площі контакту допустимий прямий струм таких р–n-переходів невеликий – 10-20 (мА), а міжелектродна ємність мала, що дає змогу застосовувати такі прилади при високих частотах струмів.
Для всіх типів р–n-переходів основною властивістю є несиметрична електропровідність, яка означає залежність величини електричного струму через перехід від полярності зовнішньої прикладеної напруги. Далі уважно проаналізуємо процеси в електронно-дірковому переході.
Зауваження. В змістовій частині матеріалу лекції розглянуті, так звані, гомопереходи (від. грец. гомо – однорідний), що створені напівпровідниками з однаковою шириною забороненої зони. У сучасній електронній техніці все більше застосування знаходять прилади з гетеропереходами (від. грец. гетеро – різнорідний), створеними між двома напівпровідниками з різною шириною забороненої зони. Причому застосування знаходять усі чотири можливі типи гетероструктур між двома різними напівпровідниками 1 і 2 . Гетеропереходи ефективно використовують у випромінювальних та фотоелектричних приладах, елементах інтегральних схем та інших. Типовими прикладами є гетеропереходи між GaAs і GaAsP, GaAs і AlGaAs, GaP і GaAsP, InP і GaInAs. Детальний аналіз процесів у гетероструктурах надається при вивченні дисципліни «Напівпровідникові прилади».
1.4. Вольт-амперна характеристика р-n-переходу
Основну властивість р–n-переходу можна сформулювати так: якщо до переходу прикладена пряма напруга, то р–n-перехід відкритий і пропускає струм, а якщо зворотна напруга, то р–n-перехід закритий і струм майже не пропускає. Залежність повного струму через р-n перехід від зовнішньої напруги називається вольт-амперною характеристикою (ВАХ) електронно-діркового переходу.
Аналітичний вираз для визначення величини струму через ідеальний р–n-перехід називають рівнянням Еберса-Молла:
|
|
(1.8) |
де Io – тепловий струм р–n-переходу, U – зовнішня напруга, що прикладена до р–n-переходу, e – основа натуральних логарифмів, фТ – тепловий потенціал.
Графічне зображення вольт-амперної характеристики, тобто залежності (1.8), наведене на рис. 1.10. Графічне зображення ВАХ ідеального електронно-діркового переходу має дві чітко визначені ділянки – I і II. При прямих напругах опір р–n-переходу незначний, а струм великий (ділянка I на ВАХ рис. 1.10). Характеристика для прямого струму спочатку має значну нелінійність: зі збільшенням напруги опір запірного шару зменшується. При напрузі у десяті частки вольта запірний шар практично зникає і струм обмежується тільки опорами n- і р-областей, які можна вважати незмінними. Внаслідок цього характеристика стає майже лінійною, а незначна нелінійність пояснюється нагріванням n- і р-областей при збільшенні прямого струму, що веде до зменшення їхнього опору.
При
зворотних напругах опір р–n-переходу набагато більший, і зворотний
струм ![]() на декілька порядків менший за прямий
(ділянка II на ВАХ рис. 1.10). Зворотну вітку ВАХ діода часто рисують в іншому
масштабі із заломом у початку координат. Зворотний струм при збільшенні
зворотної напруги потроху збільшується. Це пояснюється зменшенням дифузійної
складової струму через збільшення потенціального бар’єру, який спрямований
зустрічно до дрейфової складової струму.
на декілька порядків менший за прямий
(ділянка II на ВАХ рис. 1.10). Зворотну вітку ВАХ діода часто рисують в іншому
масштабі із заломом у початку координат. Зворотний струм при збільшенні
зворотної напруги потроху збільшується. Це пояснюється зменшенням дифузійної
складової струму через збільшення потенціального бар’єру, який спрямований
зустрічно до дрейфової складової струму.
Отже, р–n-перехід має односторонню провідність, або, як кажуть, вентильну властивість.

Рис. 1.10. Вольт-амперна характеристика ідеального р–n-переходу
При прямих напругах, що перевищують десяту частину вольта , можна знехтувати одиницею у виразі (1.8).
Наприклад, якщо ![]() , то при кімнатній температурі
, то при кімнатній температурі
 .
.
При зворотних
напругах можна знехтувати доданком ![]() , з огляду на те, що для робочого діапазону
зворотних струмів
, з огляду на те, що для робочого діапазону
зворотних струмів ![]() . Наприклад, якщо
. Наприклад, якщо ![]() , то
, то
 .
.
Отже, для практичних якісних розрахунків приймають:

Прямий і зворотний струми через р–n-перехід залежать від температури (рис. 1.9). Це зрозуміло, бо кількість як основних, так і неосновних носіїв заряду у напівпровідниках збільшується зі збільшенням температури, отже, зростають як прямий, так і зворотний струми. Підвищення температури веде до зміщення ділянки I ВАХ р–n-переходу догори, а ділянки II – вниз.
Прямий струм при нагріванні р–n-переходу
зростає не так швидко, як зворотний. Це пояснюється тим, що прямий струм
виникає, головним чином, завдяки домішковій провідності, а концентрація домішки
не залежить від температури. Сильно збільшується зворотний струм через посилену
термогенерацію пар носіїв. Кількість носіїв зарядів збільшується вдвічі зі
збільшенням температури германію на ![]() і кремнію на
і кремнію на ![]() , отже, за таким же законом змінюється
зворотний струм, що можна аналітично виразити формулою (1.11):
, отже, за таким же законом змінюється
зворотний струм, що можна аналітично виразити формулою (1.11):
|
|
(1.11) |
де To=20oC – кімнатна температура, T* – температура подвоєння зворотного струму на кожні 10oC(T*=10oC для германієвих р–n-переходів, 8oC – для кремнієвих).
Отже, якщо температура р–n-переходу із
германію збільшилася з ![]() до
до ![]() , то зворотний струм збільшився у
, то зворотний струм збільшився у ![]() рази.
рази.
При аналізі реальних процесів в електронно-дірковому переході потрібно використовувати вольт-амперну характеристику (рис. 1.11), яка дещо різняться від ідеальної (рис. 1.10), в першу чергу, зростанням зворотного струму зі збільшенням модуля зворотної напруги (ділянка II) і наявністю ділянок III і IV.

Рис. 1.11. Вольт-амперна характеристика реального р–n-переходу
Об’ємний опір бази структури з р–n-переходрм при великих рівнях інжекції зростає внаслідок значного збільшення кількості неосновних носіїв у базі. Тому, при прямому увімкненні р–n-переходу у формулі Еберса-Молла (1.8) слід враховувати опір базової області RБ й омічних контактів з виводами Rв:
|
|
(1.12) |
Основний напівпровідниковий матеріал структури визначає порогове значення прямої напруги Uпор, незначне перебільшення якої веде до значного зростання прямого струму через діод. Пряма напруга Uпор на відкритих кремнієвих діодах становить близько 0,.5…0,7 (В) і не перевищує 1,5 (В); значення Uпор для германієвих діодів 0,2…0,3 (В ) і не перевищує 0,5 (В).
Якщо у ідеального діода зворотний струм слабо залежить від зворотної напруги, то у реального діода зворотний струм зростає зі збільшенням зворотної напруги через наявність струму генерації Іген і струму витоку Івит:
|
|
(1.13) |
Реальний р–n-перехід не є нескінченно вузьким, тому в запірному шарі відбувається генерація пар електрон-дірка. Генеровані заряди розділяються електричним полем p-n–переходу і створюють струм генерації Іген. Кількість генерованих пар збільшується з розширенням переходу при збільшенні зворотної напруги. Отже, збільшується значення й струму генерації. Довжина реального p-n–переходу також не нескінченна. Поверхня напівпровідникового кристала характеризується порушеннями кристалічної ґратки і різними забрудненнями, які обумовлюють рекомбінаційно-генераційні процеси на поверхні p-n–переходу, тобто виникнення додаткового струму витоку Івит. Відносні частки струмів генерації Іген і витоку Івит у зворотних струмах діодів залежать від типу напівпровідникового матеріалу.
Коли зворотна напруга набуває певного значення Uпроб, яке має назву напруги пробою, зворотний струм різко
зростає (ділянка III на ВАХ реального р–n-переходу) – відбувається електричний пробій р–n-переходу.
При  електрони, що потрапили в зону
переходу, набувають швидкість, достатню для йонізації атомів кристала в
запірному шарі. Отримані внаслідок первинної йонізації електрони на своєму
шляху в переході йонізують нові атоми, що призводить до розвитку лавини рухомих
носіїв заряду. Отже, відбувається лавиноподібне зростання кількості додаткових
пар зарядів, тому різко зростає зворотний струм за умови практично незмінного
значення зворотної напруги. Таке явище лавинного електричного пробоюспостерігається у
широких переходах (ширина р–n-переходу більша за шлях, який
проходить електрон за час життя) при напруженості поля, більшої за
електрони, що потрапили в зону
переходу, набувають швидкість, достатню для йонізації атомів кристала в
запірному шарі. Отримані внаслідок первинної йонізації електрони на своєму
шляху в переході йонізують нові атоми, що призводить до розвитку лавини рухомих
носіїв заряду. Отже, відбувається лавиноподібне зростання кількості додаткових
пар зарядів, тому різко зростає зворотний струм за умови практично незмінного
значення зворотної напруги. Таке явище лавинного електричного пробоюспостерігається у
широких переходах (ширина р–n-переходу більша за шлях, який
проходить електрон за час життя) при напруженості поля, більшої за ![]() . Електричний пробій не руйнує р–n-перехід
за умови обмежених значень струму, і зменшення зворотної напруги відновлює
робочі процеси в р–n-переході. Зі збільшенням температури у
германієвих переходах напруга електричного пробою зменшується, у кремнієвих
переходах – напруга електричного пробою спочатку дещо збільшується, а потім зменшується.
. Електричний пробій не руйнує р–n-перехід
за умови обмежених значень струму, і зменшення зворотної напруги відновлює
робочі процеси в р–n-переході. Зі збільшенням температури у
германієвих переходах напруга електричного пробою зменшується, у кремнієвих
переходах – напруга електричного пробою спочатку дещо збільшується, а потім зменшується.
В режимі електричного пробою працюють деякі напівпровідникові прилади, наприклад, стабілітрони [див. Лекцію № 2, § 2.2.3].
Оскільки
в р–n-переході під час проходження зворотного струму виділяється
тепло, у разі недостатнього тепловідводу починає підвищуватися температура
кристала. При необмеженому зростанні струму під час тривалого ввімкнення р–n-переходу
на напругу  струм збільшується настільки, що
внаслідок неприпустимого нагрівання р–n-перехід руйнується. Це
явище називають тепловим пробоєм (ділянка IV на ВАХ рис. 1.11). Тепловий пробій – процес незворотний,
бо він неминуче веде до руйнування матеріалу напівпровідника. Тепловий пробій
означає аварійний режим, який виводить з ладу напівпровідникові прилади.
Тепловий пробій може настати і при прямому увімкненні р–n-переходу
у разі значного підвищення температури напівпровідника. Перехід із германію
руйнується при
струм збільшується настільки, що
внаслідок неприпустимого нагрівання р–n-перехід руйнується. Це
явище називають тепловим пробоєм (ділянка IV на ВАХ рис. 1.11). Тепловий пробій – процес незворотний,
бо він неминуче веде до руйнування матеріалу напівпровідника. Тепловий пробій
означає аварійний режим, який виводить з ладу напівпровідникові прилади.
Тепловий пробій може настати і при прямому увімкненні р–n-переходу
у разі значного підвищення температури напівпровідника. Перехід із германію
руйнується при ![]() , із кремнію – при
, із кремнію – при ![]() , незалежно чи перехід нагрівся струмом,
що проходить крізь нього, чи зовнішнім джерелом тепла.
, незалежно чи перехід нагрівся струмом,
що проходить крізь нього, чи зовнішнім джерелом тепла.
Зауваження.
1. У
вузьких переходах спостерігаються тунельний (зенеровський) електричний пробій [див. Лекцію № 2, § 2.2.5]: прямі переходи валентних електронів
на вільні енергетичні рівні крізь потенціальний бар’єр за умови великої
напруженості електричного поля (більшої за ![]() . Утворені в такий спосіб додаткові
електрони і дірки збільшують струм через р–n-перехід. При
тунельному пробої напруга на переході незначна, менша за 0,5 (В). Тунельні
пробої є оборотними.
. Утворені в такий спосіб додаткові
електрони і дірки збільшують струм через р–n-перехід. При
тунельному пробої напруга на переході незначна, менша за 0,5 (В). Тунельні
пробої є оборотними.
2. На практиці доводиться мати справу з поверхневими пробоями, зумовленими поверхневими забрудненнями р–n-переходу.


